光刻胶旋涂仿真
Application ID: 121451
在半导体制造过程中,光刻胶涂覆是一项关键的工艺,需要精确控制光刻胶层的厚度。通常,通过旋涂来减小光刻胶层的厚度,其基本原理是利用离心力将晶圆表面多余的光刻胶甩出,通过调整材料属性和旋转速度等参数,可以生成特定厚度的光刻胶层。
本示例模型采用二维轴对称建模,利用层流 接口中的涡流和自由表面 特征来模拟光刻胶层的变薄过程。第一个瞬态研究计算了在 2 mPas 和 8000 rpm 条件下,光刻胶厚度(初始为 10 um)在 120 s 内的变化。第二个瞬态研究使用参数化扫描来计算不同黏度和速度的光刻胶厚度。
结果表明:
- 随着晶圆的旋转,光刻胶层逐渐变薄,其厚度与理论结果(Emslie、Bonner 和 Peck 模型)相符。
- 黏度越低,旋转速度越快,光刻胶层也越薄。
备注:
- 本模型将光刻胶视为牛顿流体,没有考虑剪切稀化或剪切增稠效应以及温度对黏度的影响。如果存在非牛顿效应,应使用非牛顿本构模型。
- 未考虑光刻胶溶剂的蒸发。如果需要,可以将蒸发通量添加到自由表面 特征的通量中。
- 目前使用无滑移边界条件处理光刻胶与硅晶圆的接触面,如果存在滑移行为,可尝试其他类型的壁条件。
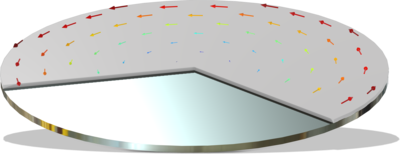
案例中展示的此类问题通常可通过以下产品建模:
您可能需要以下相关模块才能创建并运行这个模型,包括:
建模所需的 COMSOL® 产品组合取决于多种因素,包括边界条件、材料属性、物理场接口及零件库,等等。不同模块可能具有相同的特定功能,详情可以查阅技术规格表,推荐您通过免费的试用许可证来确定满足您的建模需求的正确产品组合。如有任何疑问,欢迎咨询 COMSOL 销售和技术支持团队,我们会为您提供满意的答复。
