互连结构中的空位电迁移
Application ID: 132221
随着集成电路 (IC) 技术的飞速发展,电路性能不断提升,尺寸日益缩小,识别并预防电路故障的各种因素变得尤为重要。
互连结构内的电迁移是导致电路故障的关键因素之一,其根本原因在于金属内部空位的积聚。
电迁移现象是指空位在电场、浓度、流体静应力以及温度梯度的驱动下发生迁移。本例演示了如何在 COMSOL Multiphysics® 中对这一强耦合现象进行精确与仿真。
欢迎阅读随附的博客文章“使用 COMSOL Multiphysics® 模拟电迁移”,获取更多专业解析与实用信息。
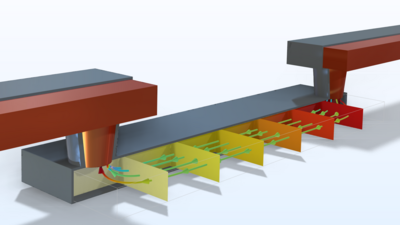
案例中展示的此类问题通常可通过以下产品建模:
您可能需要以下相关模块才能创建并运行这个模型,包括:
建模所需的 COMSOL® 产品组合取决于多种因素,包括边界条件、材料属性、物理场接口及零件库,等等。不同模块可能具有相同的特定功能,详情可以查阅技术规格表,推荐您通过免费的试用许可证来确定满足您的建模需求的正确产品组合。如有任何疑问,欢迎咨询 COMSOL 销售和技术支持团队,我们会为您提供满意的答复。



